BGA返修時出現一粒粒的珠子是什么原因造成的
我們在進行BGA返修時,通常如果控制不好的話會出現一粒粒的珠子,這些珠子是什么原因造成的呢,其實根據崴泰科技BGA返修臺廠家的經驗來看,這個就是焊接結珠。那么為什么會出現焊接結珠的情況呢。接著往下看
出現一粒粒的焊料結珠其實是因為使用的焊膏和smt工藝時焊料成球的一個特殊現象,也就是說在BGA焊接過程中出現大焊球上粘了一些小的焊料球,然后形成了極低的托腳的元件如芯片電容器。引起出現這種情況的原因是焊齊排氣作用超過了焊膏的內聚力,排氣促進了焊膏在低間隙元件下形成孤立的團粒,在軟熔時,熔化了的孤立焊膏再次從元件下冒出來,并聚結起。
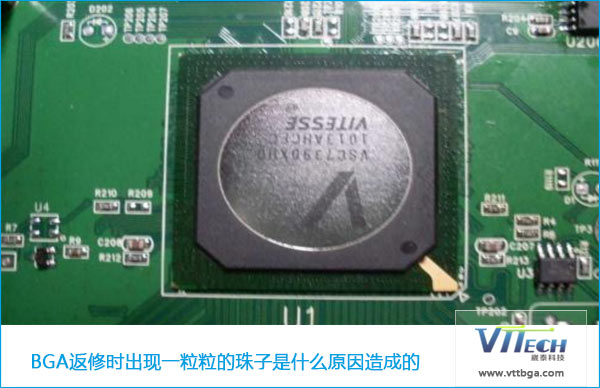
焊接結珠的原因包括:
一般情況下BGA返修焊接時出現珠子原因有以下幾點:
1、印刷電路的厚度太高。
2、焊點和元件重疊太多。
3、在元件下涂了過多的錫膏。
4、安置元件的壓力太大。
5、預熱時溫度上升速度太快。
6、預熱溫度太高。
7、在濕氣從元件和阻焊料中釋放出來。
8、焊劑的活性太高。
9、所用的粉料太細。
10、金屬負荷太低。
11、焊膏坍落太多。
12、焊粉氧化物太多。
13、溶劑蒸氣壓不足。消除焊料結珠的最簡易的方法也許是改變模版孔隙形狀,以使在低托腳元件和焊點之間夾有較少的焊膏。
總結,如果你在進行BGA返修焊接時出現一粒粒的球子,那你可以對應以上出現的問題點找原因,相信能夠解決你的問題。
本文《BGA返修時出現一粒粒的珠子是什么原因造成的》由崴泰科技BGA返修臺廠家http://www.kangmeibio.cn/撰寫,如需轉載,請注明出處,謝謝!
上一篇: BGA返修會出現哪些問題 下一篇: 為什么BGA返修焊接時會出現焊料結塊

