BGA元件植球、貼裝和返修一體化的BGA植球設備
BGA元件植球、貼裝和返修如果您具有大批量的芯片,而且對返修良率要求高,那必須要有一臺好的BGA植球設備,接下來由崴泰科技為大家介紹一款高返修良率的自動BGA植球機返修過程。

BGA元件植球、貼裝和返修設備
第一步、BGA元件植球
A:清洗BGA底部焊盤上殘留的錫膏
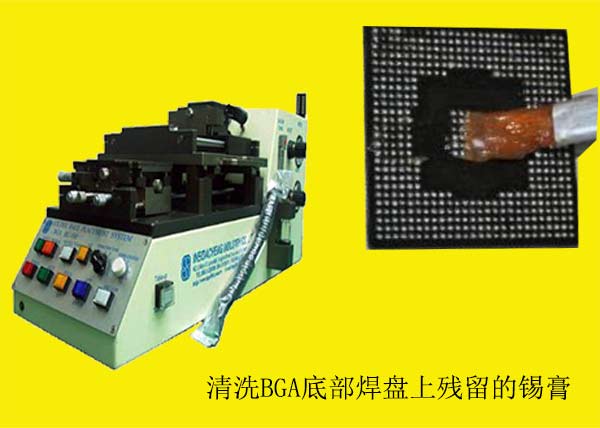
清洗BGA底部焊盤上殘留的錫膏
使用自動除錫機把PCBA焊盤上殘留的錫膏清理干凈和清理平整,可采用拆焊編織帶和扁鏟形烙鐵頭進行清理,操作時注意不要損壞焊盤和阻焊膜
B:印刷助焊劑
為了起到粘接和助焊作用,我們一般采用的是高沾度的助焊劑,在BGA底部焊盤上印刷助焊劑,保證印刷后助焊劑圖形清晰,不漫流。當然如果沒有助焊劑也可以用焊膏來替換。
C:焊球的選擇,注意材料和尺寸在選擇焊球時我們一定要選擇與BGA器件焊球材料一致的焊球,現的PBGA焊球的焊膏材料一般都是63Sn/37Pb的。還有在尺寸選擇方面,我們需要注意,如果使用高粘度助焊劑,要選擇和BGA器件焊球相同直徑的焊球,如果使用的是焊膏,那選擇比BGA器件焊球直徑小的焊球即可。
D:植球方法
使用BGA植球機BU-560進行自動植球,可以進行高精度自動錫球植入,而且具有一鍵式操作簡單方便。一顆多模裝置,提升植球效率。機器還自帶真空收集球裝置,防止錫球在操作過程中散落。
第二步、貼裝器件
重新貼裝元件時,應采用完全不同的方法。為避免損壞新的BGA,預熱(100℃至125℃)、溫度上升速率和溫度保持時間都很關鍵。與PBGA相比,CBGA能夠吸收更多的熱量,但升溫速率卻比標準的2℃/s要慢一些。
第三步、回流焊接

BGA回焊爐焊接BGA
設置焊接溫度可根據器件的尺寸,PCB的厚度等具體情況設置,BGA的焊接溫度與傳統SMD相比,要高出15度左右。
第四步、返修檢驗
BGA的焊接質量檢驗需要X光或超聲波檢查設備,在沒有檢查設備的的情況下,可通過功能測試判斷焊接質量,也可憑經驗進行檢查。
A:把焊好的BGA的表面組裝板舉起來,對光平視BGA四周,觀察是否透光、BGA四周與PCB之間的距離是否一致、觀察焊膏是否完全融化、焊球的形狀是否端正、焊球塌陷程度等。
B:如果BGA四周與PCB之間的距離是不一致說明四周溫度不均勻。
C:如果不透光,說明有橋接或焊球之間有焊料球.
D:焊球塌陷程度:塌陷程度與焊接溫度、焊膏量、焊盤大小有關。在焊盤設計合理的情況下,再流焊后BGA底部與PCB之間距離比焊前塌陷1/5-1/3屬于正常。如果焊球塌陷太大,說明溫度過高,容易發生橋接。
E:如果焊球形狀不端正,有歪扭現象,說明溫度不夠,焊接不充分,焊料再流動時沒有充分的發揮自定位效應的作用。
通過以上BGA元件植球、貼裝和返修檢驗的操作步驟,證明了BGA植球是一個細致的技術活,如果想要返修良率高,那必須使用高返修植球良率的BGA植球設備BU-560。您還可能對此感興趣>>>
| BGA返修設備大全 | |||||||
|---|---|---|---|---|---|---|---|
| BGA返修臺 | BGA植球機 | BGA植球回焊爐 | PCBA基板除錫機 | PTH返修臺 | 自動除錫機 | 視頻顯微鏡 | SMD返修站 |
| BGA返修臺又稱熱風拆焊臺是用于返修PCBA基板上的BGA器件的設備 | BGA植球機又稱BGA植錫球機是一款高精度返修BGA的自動錫球植入機 | BGA植球回焊爐又稱錫球氮氣回焊爐是一款針對BGA芯片植球后錫球回焊設備 | PCBA基板除錫機又稱PCBA除錫風刀是一款集PCBA基板器件拆焊、除錫一體的全自動除錫機 | PTH返修臺又稱小錫爐是一款用于PCBA基板PTH通孔組件移除和焊接的返修設備 | 自動除錫機又稱BGA除錫風刀是一款針對BGA的PAD上殘留焊料進行清除的設備 | 高清視頻顯微鏡是一款采用高景深,高性價比的顯微鏡 | SMD返修含熱風拆焊臺VT-220,適用多種元器件的拆焊 |
本文由崴泰科技BGA返修臺廠家http://www.kangmeibio.cn撰寫,如需轉載請注明出處,謝謝合作!

